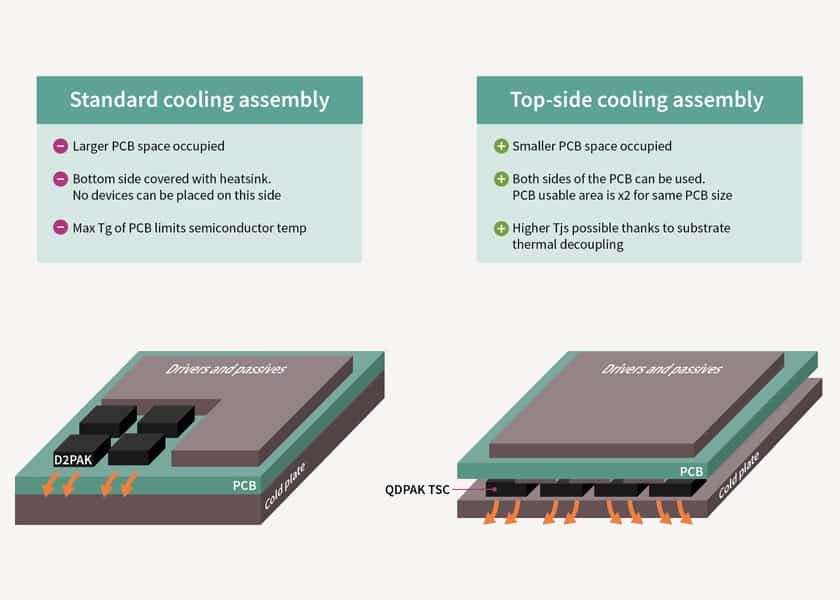
Le tendenze verso una maggiore densità di potenza e l’ottimizzazione dei costi dominano gli obiettivi di sviluppo di applicazioni efficienti ad alta potenza che creano un valore imprescindibile per segmenti come l’elettromobilità. Per spingere su questi limiti, Infineon Technologies ha annunciato oggi di aver registrato con successo i suoi package di raffreddamento top-side QDPAK e DDPAK, ideali per i MOSFET ad alta tensione, come standard JEDEC. Questa registrazione consolida ulteriormente l’obiettivo di Infineon di aiutare a stabilire un’ampia adozione di package TSC in nuovi design con tipologie standard. Inoltre, ciò fornisce più flessibilità e nuove motivazioni ai produttori OEM per differenziare i propri prodotti sul mercato e portare la densità di potenza a un livello superiore.
“In qualità di fornitore di soluzioni avanzate, Infineon continua a influenzare l’industria dei semiconduttori attraverso tecnologie di packaging e processi di produzione innovativi”, ha affermato Ralf Otremba, Lead Principal Engineer for High Voltage Packaging, Infineon. “I nostri package avanzati di raffreddamento sul lato superiore apportano vantaggi significativi a livello di dispositivo e sistema per soddisfare le impegnative esigenze di innovativi progetti di potenza. La standardizzazione del profilo del package contribuirà ad alleviare una delle principali preoccupazioni di progettazione degli OEM per le applicazioni ad alta tensione, garantendo la compatibilità pin-to-pin tra i fornitori.
Per più di 50 anni, l’organizzazione JEDEC è stata leader globale nello sviluppo di standard aperti e innovazioni per l’industria microelettronica per un’ampia gamma di tecnologie, comprese le linee guida dei contenitori. JEDEC ha accettato come standard package per semiconduttori come i dispositivi a foro passante (THD) TO220 e TO247, dispositivi che sono stati utilizzati in modo pervasivo negli ultimi decenni e sono ancora oggi un’opzione nei nuovi design di caricabatterie di bordo (OBC), sistemi ad alta tensione (HV) e convertitori DC-DC a bassa tensione (BT).
La registrazione dei design dei package TSC a montaggio superficiale (SMD) QDPAK e DDPAK segna una nuova era per i package outline, inaugurando un’ampia adozione da parte del mercato della tecnologia TSC in sostituzione rispettivamente di TO247 e TO220. Con i vantaggi di questa tecnologia, la nuova registrazione della famiglia di package JEDEC, secondo lo standard MO-354, funge da fattore chiave per la transizione delle applicazioni industriali e automobilistiche ad alta tensione ai progetti con raffreddamento superiore nelle piattaforme di nuova generazione.
Infineon ha progettato i modelli SMD QDPAK e DDPAK per offrire capacità termiche equivalenti con prestazioni elettriche migliorate rispetto ai precedenti THD TO220 e TO247. Sulla base di un’altezza standard di 2,3 mm per il package QDPAK e DDPAK per dispositivi HV e LV, gli sviluppatori possono ora progettare applicazioni complete come la conversione OBC e DC-DC con tutti i dispositivi SMD TSC che misurano la stessa altezza. Rispetto alle soluzioni esistenti che richiedono un sistema di raffreddamento 3D, i nuovi standard facilitano la progettazione e consentono di ridurre i costi di sistema per il raffreddamento.

Inoltre, l’imballaggio TSC offre una resistenza termica fino al 35% inferiore rispetto ai sistemi standard con raffreddamento sul lato inferiore (BSC). Consentendo l’uso di entrambi i lati del PCB, i package TSC offrono un migliore utilizzo dello spazio su scheda e una densità di potenza di almeno due volte superiore. La gestione termica è migliorata anche dal disaccoppiamento termico dal substrato poiché la resistenza termica dei conduttori è molto più elevata rispetto al lato superiore esposto del package. Grazie alle prestazioni termiche migliorate, non è necessario impilare schede diverse. Anziché combinare FR4 e IMS, un solo FR4 è sufficiente per tutti i componenti e richiede anche meno connettori. Queste funzionalità forniscono una distinta base (BOM) complessiva che alla fine riduce il costo complessivo del sistema.
Oltre alle migliori capacità termiche e di alimentazione, la tecnologia TSC offre anche un design ottimizzato per una maggiore affidabilità. Ciò è possibile grazie al posizionamento dei driver, che possono essere posizionati molto vicino all’interruttore di alimentazione di potenza. La bassa induttanza parassita dell’anello di commutazione del driver riduce i parassiti dell’anello e porta a un minor ronzio sul gate, prestazioni più elevate e un minor rischio di guasti.
Ulteriori informazioni sono disponibili ai seguenti link: www.infineon.com/ddpak e www.infineon.com/obc



