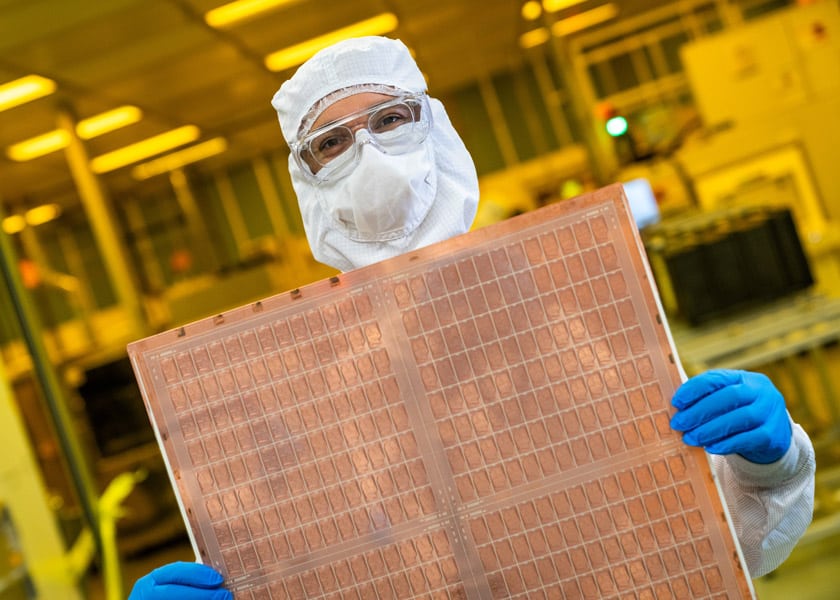
I substrati di vetro aiutano a superare i limiti dei materiali organici consentendo un miglioramento significativo nelle regole di progettazione necessarie per i futuri data center e i prodotti di intelligenza artificiale.
Intel ha annunciato oggi uno dei primi substrati in vetro per packaging avanzato di prossima generazione, tecnologia che dovrebbe affermarsi verso la fine di questo decennio. Secondo l’azienda, questo rivoluzionario risultato consentirà di fare avanzare la Legge di Moore per fornire applicazioni incentrate sui dati.
“Dopo un decennio di ricerca, Intel ha ottenuto substrati in vetro leader del settore per packaging avanzaoi. Non vediamo l’ora di fornire queste tecnologie all’avanguardia che andranno a beneficio dei nostri attori chiave e dei clienti delle fonderie per i decenni a venire”, ha dichiaratro Babak Sabi, Intel senior vice president and general manager of Assembly and Test Development.
Rispetto ai substrati organici odierni, il vetro offre proprietà distintive come l’eccezionale planarità e una migliore stabilità termica e meccanica, con conseguente possibilità di maggiore densità di interconnessione. Questi vantaggi consentiranno ai chip architect di creare insiemi di chip ad alta densità ed elevate prestazioni per carichi di lavoro ad alta intensità di dati in grado di alimentare sistemi di intelligenza artificiale (AI) sempre più avanzati. Intel ritiene di essere sulla buona strada per fornire al mercato soluzioni complete di substrati in vetro nella seconda metà di questo decennio, consentendo al settore di continuare a far avanzare la Legge di Moore oltre il 2030.
Entro la fine del decennio, l’industria dei semiconduttori raggiungerà probabilmente i suoi limiti nella capacità di packaging utilizzando materiali organici che consumano più energia e comportano limitazioni come restringimento e deformazione. La scalabilità è fondamentale per il progresso e l’evoluzione dell’industria dei semiconduttori e i substrati di vetro rappresentano un passo successivo praticabile ed essenziale per la prossima generazione di semiconduttori.

Per sviluppare le sempre più utilizzate soluzioni chiplet, saranno essenziali miglioramenti nella velocità di segnalazione, nell’erogazione di potenza, nelle regole di progettazione e nella stabilità dei substrati del package. I substrati di vetro possiedono proprietà meccaniche, fisiche e ottiche superiori, che consentono di collegare più transistor in un package, fornendo una migliore scalabilità e consentendo l’assemblaggio di sempre più grandi e complessi chiplet (chiamati “system-in-package”) rispetto ai substrati organici in uso oggi. I chip architect avranno la possibilità di utilizzare più chiplet in un unico pacchetto ancora più piccolo, ottenendo al contempo miglioramenti in termini di prestazioni e densità con maggiore flessibilità e costi complessivi e consumo energetico inferiori.
I substrati in vetro verranno inizialmente introdotti nel mercato dove possono essere sfruttati maggiormente: applicazioni e carichi di lavoro che richiedono soluzioni con fattore di forma più grande (ad esempio data center, intelligenza artificiale, grafica) e capacità di velocità più elevate.
I substrati di vetro possono tollerare temperature più elevate, offrire il 50% in meno di distorsione del modello e avere una planarità bassissima che facilita i processi litografici e avere la stabilità dimensionale necessaria per una sovrapposizione di interconnessione layer-layer particolarmente stretta. Come risultato di queste proprietà, è possibile un aumento di 10 volte della densità di interconnessione sui substrati di vetro. Inoltre, le proprietà meccaniche migliorate del vetro consentono di realizzare contenitori con fattore di forma molto grandi con rese di assemblaggio molto elevate.
La tolleranza dei substrati di vetro alle temperature più elevate offre inoltre ai chip architect flessibilità su come impostare le regole di progettazione per l’erogazione di potenza e l’instradamento del segnale perché dà loro la possibilità di integrare perfettamente interconnessioni ottiche, nonché incorporare induttori e condensatori nel vetro con temperature di lavorazione più elevate. Ciò consente migliori soluzioni di erogazione di potenza ottenendo al contempo la segnalazione ad alta velocità necessaria con una potenza molto inferiore. Questi numerosi vantaggi avvicinano il settore alla capacità di realizzare 1 trilione di transistor in un singolo package entro il 2030.
Intel vanta una lunga storia nella realizzazione di imballaggi di nuova generazione, avendo guidato il settore nella transizione dalle confezioni in ceramica a quelle organiche negli anni ’90, ed essendo stata la prima a realizzare confezioni senza alogeni e senza piombo ed essendo l’inventore di die integrati avanzati e delle prime tecnologie di impilamento 3D. Per questo motivo Intel è stata in grado di sbloccare un intero ecosistema attorno a queste tecnologie, dai fornitori di apparecchiature, prodotti chimici e materiali ai produttori di substrati.
Con questa tecnologia e con le recenti innovazioni PowerVia e RibbonFET, Intel intende raggiungere i 1.000 miliardi di transistor in un singolo package entro il 2030.



